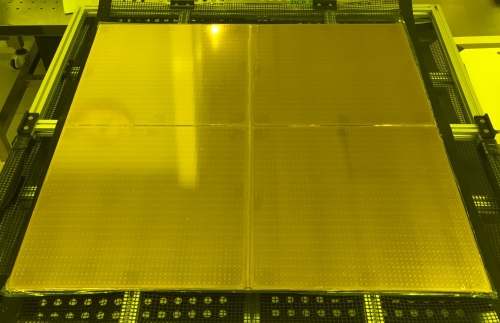
반도체 패키징 중견기업 네패스가 세계 최초로 차세대 반도체 패키지 기술로 주목받는 PLP(패널레벨 패키지, Panel Level Package) 양산에 나섰다.
15일 업계에 따르면 네패스는 고가의 반도체 장비와 소재를 활용하는 기존의 WLP(웨이퍼레벨 패키지, Wafer Level Package) 기술을 LCD 장비와 소재를 활용하는 PLP 기술로 전환하는데 성공해 대량 생산에 들어갔다.
LCD 기술과 WLP의 장점을 모은 PLP는 WLP의 물리·전기적 특성과 열방출 특성은 유지하면서 대형 패널 상태로 다량의 칩을 한 번에 패키징하는 기술이다. WLP는 원형 기판 위에 가공된 웨이퍼를 잘라 칩을 올린 뒤 재배선 작업을 하는 반면 PLP는 네모난 기판 위로 칩을 올려 작업한다. 네패스 관계자는 “이전의 둥근 형태 패키징을 사각형 형태로 구현해 이전에는 쓸 수 없었던 모서리 부분도 사용할 수 있어 효율적”이라며 “이론적으로만 기술이 존재해왔는데 공정화해서 양산한 것은 네패스가 세계 최초”라고 밝혔다.
김남철 반도체사업부장은 “PLP는 이달부터 스마트폰에 우선적으로 적용돼서 칩을 생산하고 있다. 스마트폰의 고사양 경쟁이 치열해지면서 반도체 첨단 패키지 기술에 대한 수요가 늘고 있다”며 “기존 공정의 생산 원가를 대폭 절감시킨 PLP 기술은 패키지 시장의 판도를 완전히 바꾸게 될 것”이라고 밝혔다.
1990년 설립된 네패스는 WLP, 팬아웃(FO) 패키지, PLP 등 반도체 패키지 사업에서 모듈 사업을 포함해 올해 상반기 선보일 뉴로모픽 인공지능 반도체 생산 사업으로 영역을 확대해 왔으며 기술 개발 역량을 강화하며 칩 메이커로서의 입지를 확고히 해왔다.





